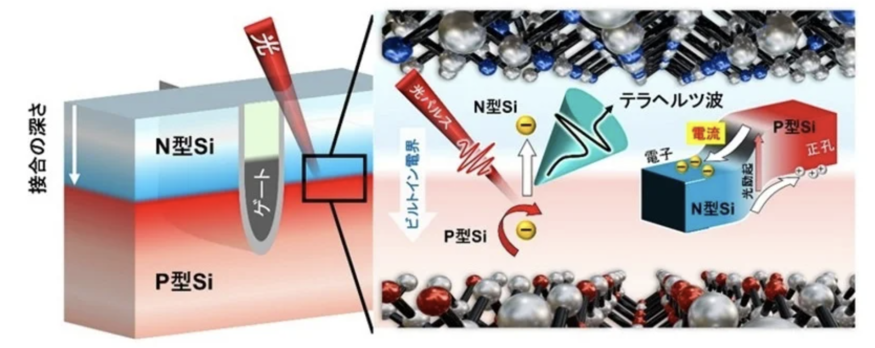
[더구루=정예린 기자] 삼성전자가 미국·일본 대학과 함께 반도체 내부 구조를 나노미터(nm) 단위로 분석하는 레이저 기반 기술을 새롭게 구현했다. 비접촉·비파괴 방식으로 칩 속 접합 상태를 진단할 수 있어 고집적 반도체 불량률을 낮추고 공정 품질 관리 수준을 크게 높일 수 있을 전망이다.
8일 일본 오카야마대학교에 따르면 최근 삼성전자, 미국 라이스대학교 등과 함께 실리콘 웨이퍼 속 반도체를 자르지 않고 PN 접합의 깊이를 측정할 수 있는 새로운 분석 기술을 공동 개발했다. 해당 성과는 지난달 국제학술지 ‘빛, 과학과 응용(Light: Science & Applications)’을 통해 발표됐다.
연구진이 개발한 방식은 초고속 레이저를 웨이퍼 표면에 쏘면 발생하는 테라헤르츠(THz)파를 감지해 내부 구조를 분석하는 원리를 바탕으로 한다. 레이저에 반응한 전자들이 이동하면서 방출하는 전자기파에는 접합이 형성된 위치와 깊이에 대한 정보가 담겨 있다. 이 신호를 분석하면 접합이 얼마나 얕은 위치에 자리잡고 있는지 nm 수준으로 추정할 수 있다.
PN 접합은 전류를 제어하는 반도체의 핵심 구조다. 최근 고성능 칩은 이 접합을 수십~수백nm 단위로 얕게 형성해야 하며 깊이가 조금만 어긋나도 소자 동작에 치명적인 영향을 준다. 지금까지는 시료를 절단하거나 복잡한 전기적 분석을 거쳐야만 접합 깊이를 파악할 수 있어 정밀성과 효율을 모두 만족시키기 어려웠다.
연구진이 개발한 기술은 이같은 한계를 비접촉 방식으로 해결한다는 점에서 주목받고 있다. 웨이퍼에 손상을 주지 않고도 내부 구조를 직접 확인할 수 있을 뿐 아니라 반복 측정과 공정 자동화에도 적합하다. 연구진은 복잡한 전자 이동과 테라헤르츠파 발생 사이의 관계를 단순한 수식 모델로 설명함으로써 제조 현장에서도 손쉽게 활용할 수 있도록 했다.
산업적 응용 가능성도 다양하다. 접합 깊이 측정뿐 아니라 △도핑 농도 분석 △공정 균일성 진단 △내부 전기장 평가에도 활용될 수 있다. 특히 GAA(게이트올어라운드) 트랜지스터나 3D 적층 구조처럼 구조가 복잡하고 민감한 차세대 공정에서는 기존 검사 방식으로는 어려웠던 진단이 가능해진다. 또 인공지능(AI) 기반 분석 알고리즘과 결합할 경우 테라헤르츠파 신호를 활용한 자동화 검사 시스템으로 확장될 수 있을 것으로 기대된다.

























